在现有过程的范围内,该消息称SK Hynix被称为引入
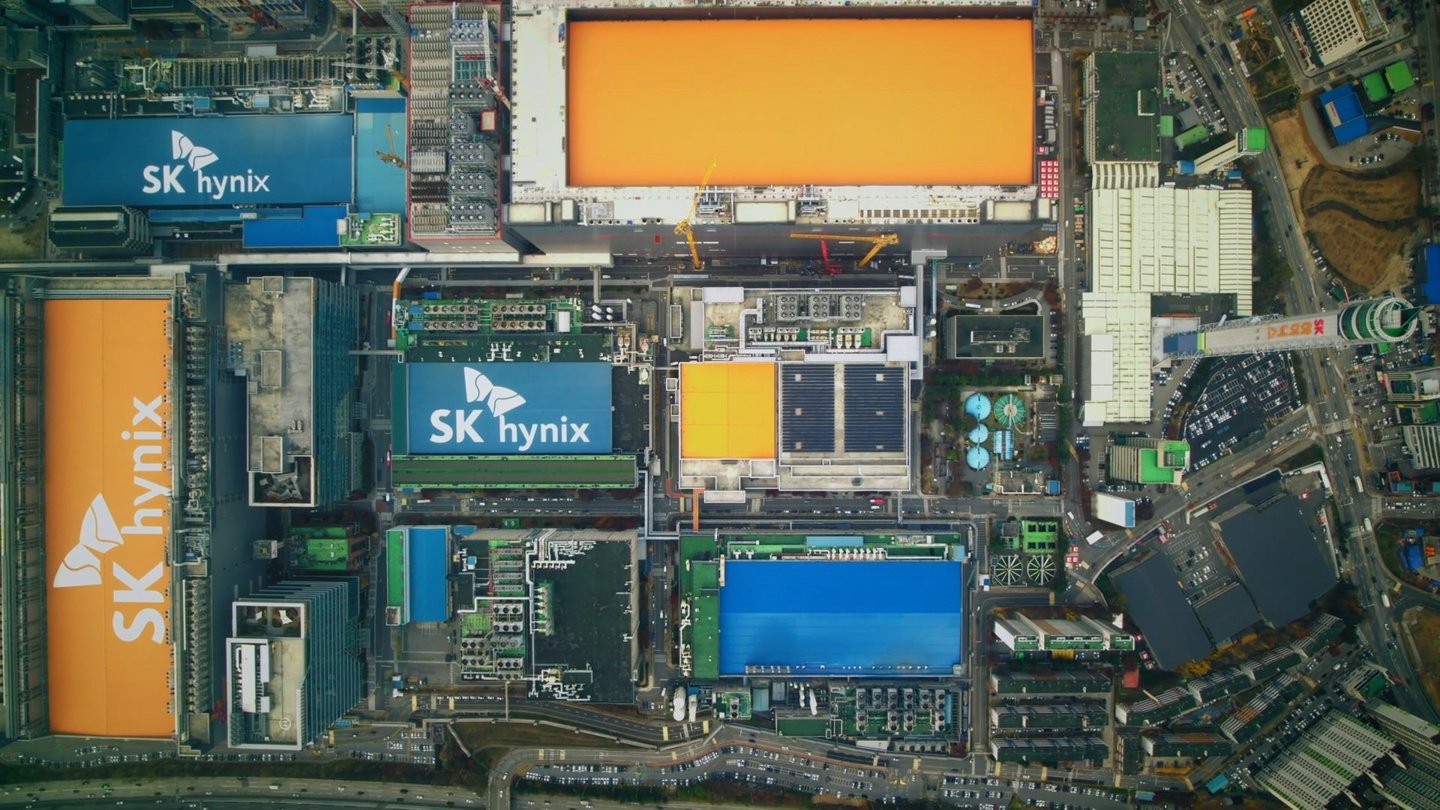 韩国媒体Etnews在本月第9月报道的是,为了应对先进记忆晶片的厚度,SK Hynix考虑了引入高级晶圆切割技术(例如飞秒激光器)的引入。据报道,SK Hynix当前使用的基本晶圆切割技术包括机械刀片切割(使用钻石磨轮)和无形切割(内部产生裂缝),但它们只能适应约100μm及以上且约50μm的晶圆。目前,高级内存的晶圆厚度减小,尤其是在未来的400多层,需要多层堆叠和有限的堆栈高度,并且需要混合粘合物以将存储单元连接到外围电路。该报告指出,Skhynix正在与激光设备合作伙伴合作,探索用于晶圆切割设备的新评论项目。该公司已与一些合作伙伴进行了技术试验,以探索Variou可能的技术途径,包括前沟前,直接和完全使用激光分离。
韩国媒体Etnews在本月第9月报道的是,为了应对先进记忆晶片的厚度,SK Hynix考虑了引入高级晶圆切割技术(例如飞秒激光器)的引入。据报道,SK Hynix当前使用的基本晶圆切割技术包括机械刀片切割(使用钻石磨轮)和无形切割(内部产生裂缝),但它们只能适应约100μm及以上且约50μm的晶圆。目前,高级内存的晶圆厚度减小,尤其是在未来的400多层,需要多层堆叠和有限的堆栈高度,并且需要混合粘合物以将存储单元连接到外围电路。该报告指出,Skhynix正在与激光设备合作伙伴合作,探索用于晶圆切割设备的新评论项目。该公司已与一些合作伙伴进行了技术试验,以探索Variou可能的技术途径,包括前沟前,直接和完全使用激光分离。 上一篇:富士将在2025年推广X
下一篇:没有了
下一篇:没有了





